반도체 소자에서 대표적인 신뢰성 열화중 HCI (Hot Carrier Injection)에 대해서 공부.
- HCI란?
높은 에너지(Drain 전압에 의한)를 받은 electron/hole에 의해 Impact ionization이 발생 하게되고, 캐리어 충돌에 의해 NMOS기준으로 Hot electron에 의해 발생한 electron이 Silicon 격자 충돌에 의해 e/h pair가 생성되어 electron은 Oxide 내부에 Trap 되며 hole은 substrate electrode로 빠져나가게 되며 이때의 전류를 Isub이라고 한다. - HCI 측정 방법
위에 얘기했던대로 HCI에 의해 발생한 Isub 전류 센싱을 통해 HCI 를 간접적으로 측정할 수 있다. - HCI 열화에 따른 현상
Drain의 위치와 가까운 Gate Oxide의 Quality가 낮아지고 Cox (Gate Oxide Capacitance) 값이 낮아진다. 이에 따라 Gate 절연막 유전율이 열화(하향)된다. --> HCI (stress)에 의해 Cox가 낮아지고 Vth가 높아진다. 또한, Cox 변화에 따라 SS 특성 열화된다(하기 수식 참고).


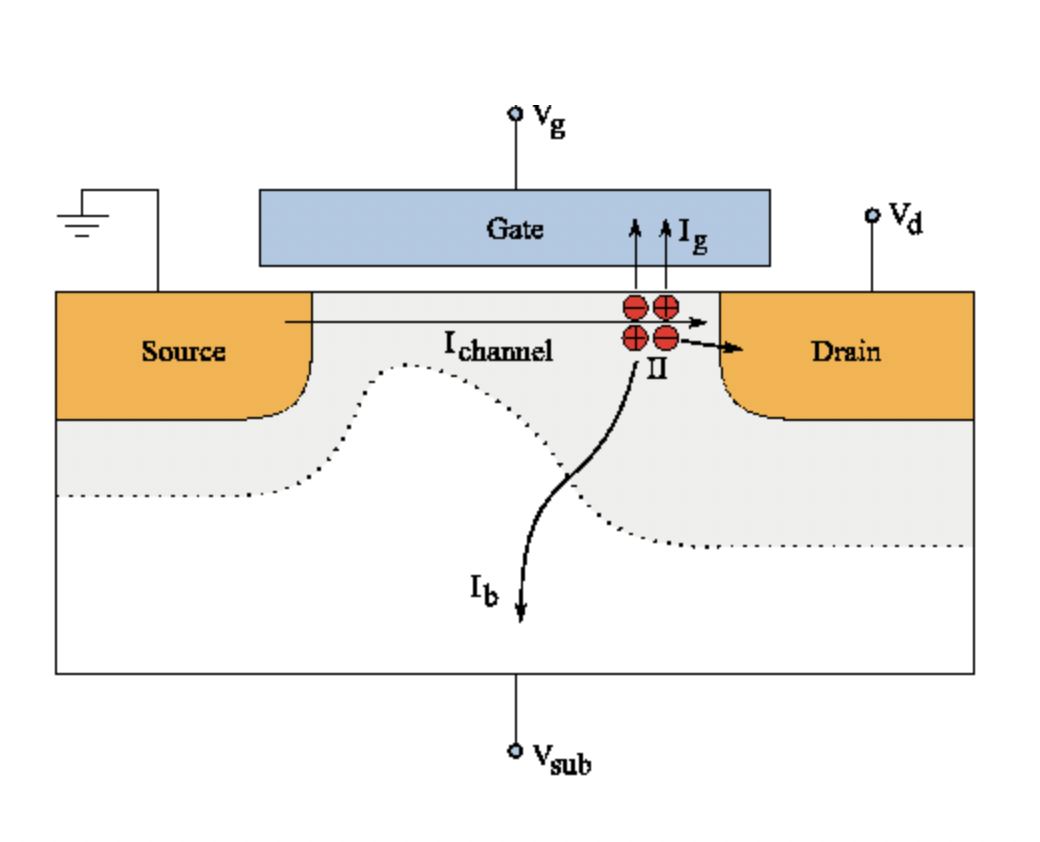
- HCI 열화 방지 방법
LDD (lightly Doped Drain)를 통해 Lateral Field를 낮추어 Impact Ionization 발생 확률을 낮춘다. - 추가 학습 내용
- Trap Mechanism (HCI Hot electron에 의한), Dangling Bond, Hydrogen(Si-H)
- Isub이 Vg -> VD/2 ~ VDD 영역에서 감소하는 이유
*Reference
- https://m.blog.naver.com/balance-five/222145781118
Threshold Voltage(문턱 전압)의 정의와 영향을 미치는 요인
Threshold voltage는 Substate의 surface에 minority carrier에 의해 inversion layer가 형성되는 순간의...
blog.naver.com
- https://engineering.purdue.edu/~ee650/downloads/Lecture28.pdf
'반도체 연구원의 하루 > 소자 신뢰성' 카테고리의 다른 글
| [이론] MOSFET Breakdown voltage: Snapback breakdown (0) | 2024.03.23 |
|---|---|
| [신뢰성] HCI Mechanism - 요약 (0) | 2023.08.28 |
